





來源:半導體行業觀察|
發表時間:2025-05-12
點擊:2119
眾所周知,制造用于先進邏輯應用的芯片始于電路設計。該過程發生在不同的層面:從晶體管到標準單元、布局布線,直至系統設計層。構成電路設計版圖的圖案隨后被寫入光掩模上。如今,這由利用電子束的掩模寫入設備完成,例如可變形狀束 (VSB:variable shaped beam) 掩模寫入機和多光束掩模寫入機 (MBMW:multi-beam mask writer)。
接下來,在光刻曝光步驟中,掩模上的圖案被縮小并投射到目標晶圓上方的光刻膠層上。光刻膠顯影后,采用先進的圖案化和蝕刻技術,將印刷的圖案進一步轉移到基板的底層。
在光刻曝光步驟中,預期的電路版圖圖像會發生扭曲。這是由于光線在光刻掃描儀和掩模版中的傳播方式,會發生衍射。這種扭曲會導致圖像保真度下降,即目標圖像與晶圓上印刷結構之間的差異。后者會出現一些不規則之處,例如線寬比設計值更窄或更寬,從而影響邊緣位置的完整性和分辨率。因此,光學鄰近效應校正 (OPC) 技術被應用于版圖設計數據:它們在將圖案寫入掩模版之前對其進行校正,以最大限度地減少從設計到晶圓的誤差。
光刻、掩模和OPC技術的進步對于推動后續邏輯技術在功耗-性能-面積-成本(PPAC)方面的改進至關重要。分辨率的提高是通過縮短曝光步驟所用光的波長或增加光刻掃描儀的數值孔徑(NA)來實現的。后者的例子包括從193納米到193納米浸沒式光刻的演進、極紫外光刻(EUV)以及即將推出的0.55NA極紫外光刻(High NA EUV)。
設計方面也隨之發展,以跟上光刻技術改進帶來的分辨率提升。后續技術節點對間距微縮的要求超過了光刻技術的進步。因此,先進邏輯芯片的設計從2-D Manhattan布局轉向關鍵層中的1-D Manhattan布局(圖1)。在基于2-D Manhattan的設計中,矩形結構用于沿垂直和水平方向對齊。相比之下,關鍵層中的一維設計則將結構沿每層垂直或水平方向對齊。雖然1-D Manhattan布局提供了密集的表示,但它也有一個缺點:當從一條金屬線到相鄰金屬線進行電氣連接時,必須實現一個包含大量過孔的額外層——這增加了晶圓成本和電流的路徑長度。
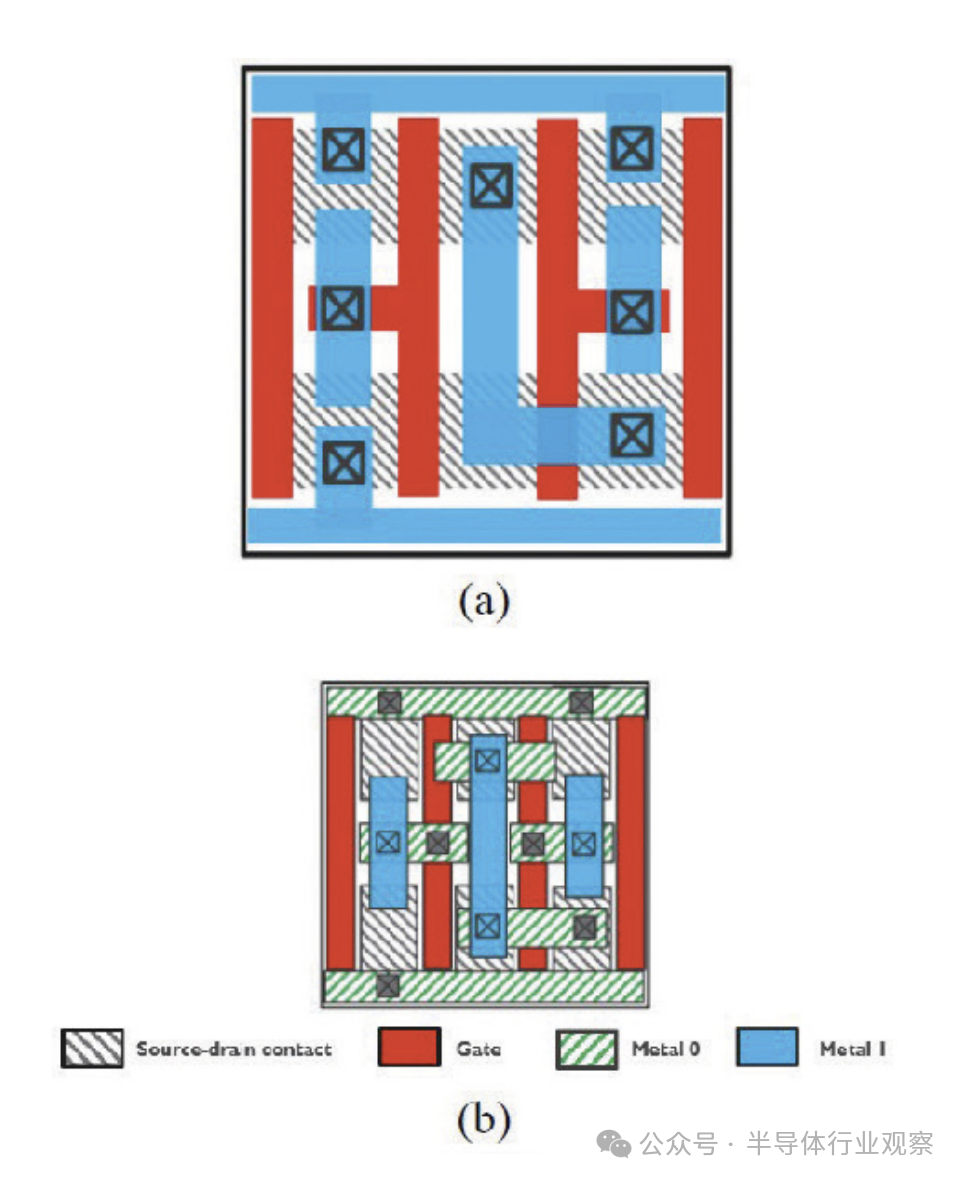
所有這些,都有一個“怪異之處”:盡管如今的設計師在設計中追求矩形的曼哈頓結構,但這些結構在掩模版和晶圓上始終呈現彎曲狀態(圖2)。這是掩模版寫入器和光刻掃描儀工作方式的固有結果,它們分別充當電子束和光的低通濾波器。因此,曼哈頓設計在通過系統傳輸時會變成彎曲的,從而在最終圖案中引入額外的誤差。

幾年前,光刻界開始探索在光掩模上寫入電路圖案時引入曲線形狀(curvilinear shapes)的想法。多電子束掩模版寫入工具的出現促進了這一想法,該工具首次實現了在掩模版上寫入復雜形狀。這有助于進一步減少從基于曼哈頓的設計到晶圓上曲線表示過程中出現的誤差。
最近,業界還考慮使用新的OPC算法,將曼哈頓設計版圖調整為掩模版和晶圓上更復雜的曲線形狀。傳統OPC和逆向光刻技術(ILT:inverse lithography technology)中的新型“曲線”OPC技術開始出現,作為改善光刻步驟工藝窗口的一種方式。
曲線掩模和OPC技術近期已成為半導體行業的熱門研發課題,2025 SPIE先進光刻和圖形化會議上投稿數量的不斷增長也反映了這一點。
曲線(Curvilinear)OPC和掩模策略仍然基于曼哈頓電路設計布局。下一步,imec提議在設計階段就引入曲線幾何形狀和路徑( curvilinear geometries and paths),這是一個創新概念,其優勢遠超曲線OPC和掩模策略。與當前的路線圖演進不同,曲線設計有望在降低晶圓制造成本的同時實現技術節點過渡,同時提升電氣性能。因此,正如imec在2025年SPIE先進光刻與圖案化會議上的受邀論文中所展示的那樣,它有望徹底改變半導體行業。我們通過三個用例展示了其優勢。
用例 1:通過曲線設計簡化中段 (MOL) 和后端 (BEOL) 層及過孔
曲線設計被證明有益的第一個用例是標準單元的布線練習以及緊密間距金屬層的布局布線設計。
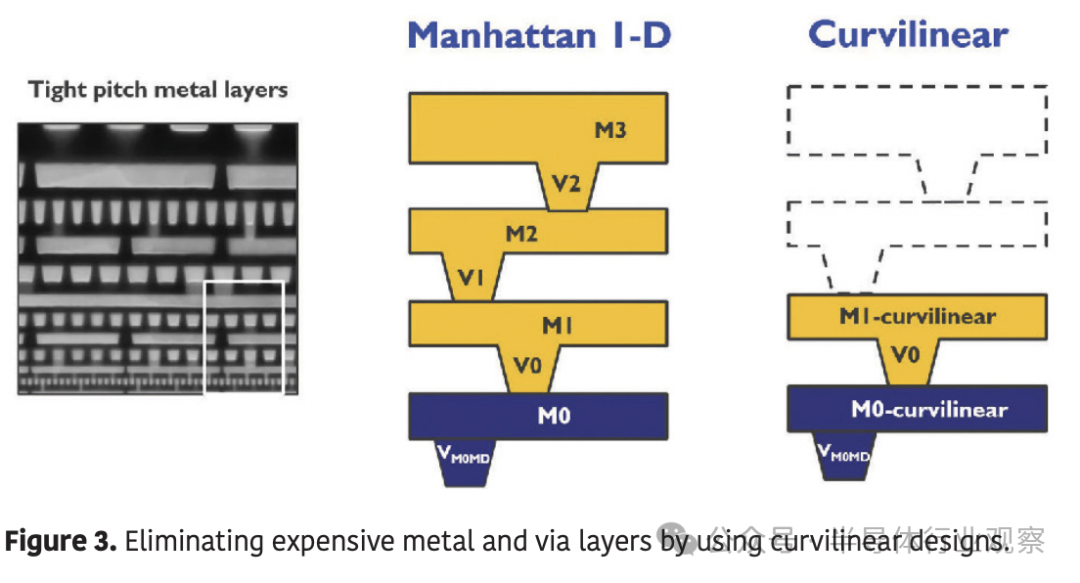
對于14A及以上晶圓代工廠,在標準單元和緊密間距金屬層中采用曲線設計,可以合并最昂貴的MOL和BEOL層,從而減少所需的金屬層數量,從而消除相應的過孔(圖3)。仿真表明,如果曲線設計能夠成功消除M2和V1(一層金屬層),則可以實現晶圓成本降低7%,晶圓廠周轉時間縮短5%,工藝步驟減少7%。Imec的研究人員還評估了此特定用例對電氣性能的影響:與標準單元級的曼哈頓1D設計相比,曲線設計的性能提升了約5%(圖4)。性能提升的指標是延遲時間的減少,這是由于省去了額外的過孔并縮短了電流的金屬路徑。
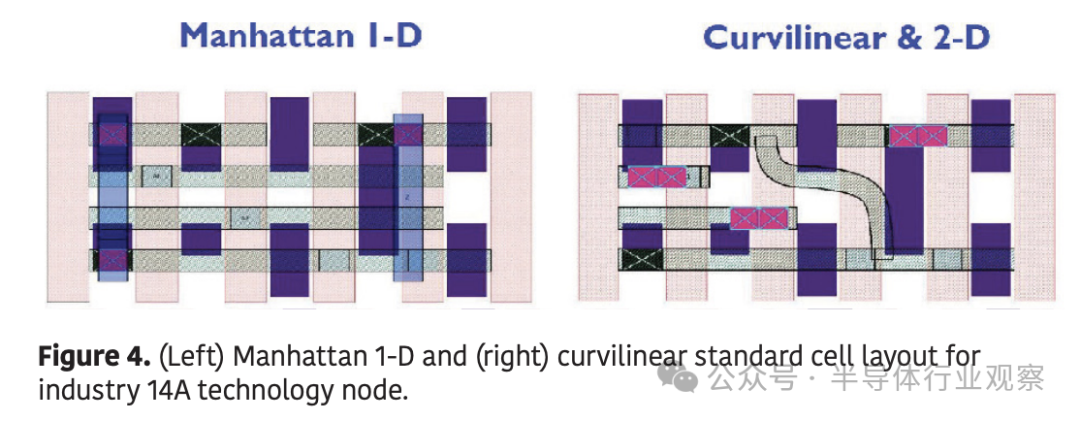
用例 2:通過曲線設計實現源漏接觸和柵極重新布線
曲線設計的第二個應用場景是構成 CMOS 器件的 n 型和 p 型晶體管的源漏接觸和柵極之間的布線。在當今的一維曼哈頓設計中,它們只能形成“南北”(north-south)方向的電氣連接。因此,連接 n 型和 p 型晶體管的源漏和柵極的唯一方法是添加額外的金屬層和過孔層。這使得電流可以向上穿過過孔,沿著額外層中的布線金屬流動,然后向下穿過另一個過孔連接到另一個源漏接觸。因此,會產生電氣和成本方面的損失。
然而,使用曲線形狀連接源極/漏極觸點和柵極可以消除使用額外金屬層的電連接(圖5)。降低M0布線資源的利用率可以進一步縮小單元面積。將此概念應用于業界代工廠14A節點的邏輯標準單元,可實現20%的面積縮小(相當于從5T單元設計過渡到4T單元設計),同時抑制晶圓制造成本。
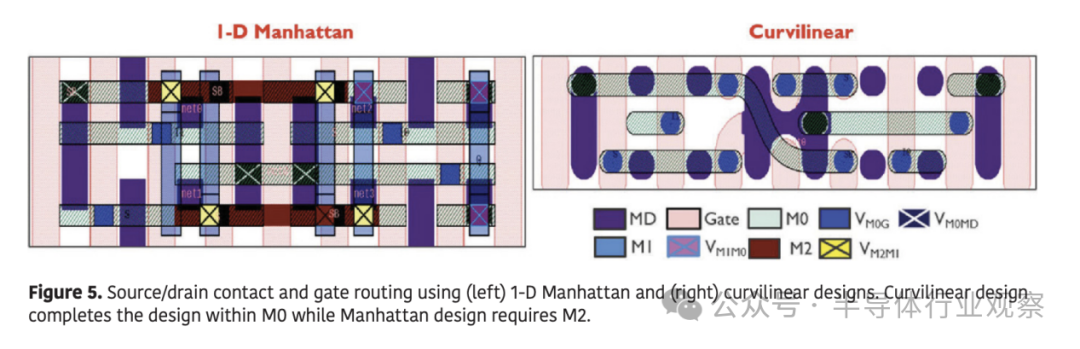
用例 3:曲線布局布線設計
與用例 1 和 2 相比,imec 認為曲線幾何在布局布線層面具有最大的潛力,其應用范圍涵蓋標準單元上方的所有金屬布線層。與之前描述的用例不同,這種方法需要更大的工業投入,包括全面啟用布局布線工具和在整個設計空間內提供寄生參數提取 EDA 解決方案。imec 預計,通過實現這一目標,曲線技術將在未來的邏輯技術節點擴展中發揮關鍵作用。
使用曲線設計的整體優勢可以通過功率-性能-面積-成本 (PPAC) 品質因數來體現。目前,雖然具體目標各不相同,但節點間轉換目標的一個典型示例包括面積減少 20%、性能提升 15% 和功耗降低 15%。如今,這些 PPA 優勢是以晶圓制造成本為代價的:業界試圖將成本增幅限制在節點間 20% 以內。根據 imec 的估計,與使用 14A 曼哈頓 1-D 設計相比,通過在設計版圖中添加曲線形狀,可以進一步減少面積,同時提升功率/性能。這意味著業界可以在不縮小尺寸(即間距)的情況下實現 10A 的進展。更重要的是,這些優勢還帶來了成本的降低。這是圖案化領域的設計技術協同優化 (DTCO) 如何進一步增強節點間轉換的 PPAC 優勢的絕佳示例。
由于多種原因,建立曲線設計極具挑戰性。迄今為止,尚未找到能夠精確表示曲線形狀數據,同時控制整個制造生態系統數據量的解決方案。一種方案是使用分段直線數據表示法(一種由連接點的直線組成的幾何結構)來近似曲線形狀(圖 6)。然而,使用這種表示法會大幅增加數據量。數據量過大是業界關注的問題,因為商用 EDA 工具難以處理如此龐大的數據量,而且數據還必須在整個制造生態系統中進行傳輸。

此外,還需要建立包含器件組件和布局特征信息的專用設計規則。此外,還必須找到一種方法來驗證設計的正確性——即所謂的設計規則檢查 (DRC)。所有這些都必須能夠通過商用 EDA 工具進行管理。
由于上述優勢,曲線設計理念有望更高效地利用高數值孔徑 EUV 光刻技術,使其成為先進邏輯節點的補充技術選擇。此外,這一創新理念也有望擴展低數值孔徑 EUV 光刻技術,尤其是 193nm 浸沒式光刻技術,這與其他應用領域息息相關,例如圖像傳感器、超透鏡或汽車芯片,這些領域均可從制造成本的降低中受益。
[聲明]本文版權歸本網站所有,轉載請聯系本網客服微信號:suxueer0823。本文僅代表作者個人觀點,作者不對內容的準確性、可靠性或完整性承擔明示或暗示的保證。文章內容僅讀者學習參考,并不構成任何投資及應用建議。本站擁有對此聲明的最終解釋權。
本網尊重知識產權,因整理資料所需,本文中引用部分公開第三方的數據、圖片等內容,其所屬的知識產權歸屬原作者,且凡引用的內容均在文中標注了原文出處、原作者。若版權所有者認為本文涉嫌侵權或其他問題,請聯系我方(聯系方式:0755-86060912)及時處理。
本網力求數據嚴謹準確,但因受時間及人力限制,文中內容難免有所紕漏。如有重大失誤失實,敬請讀者不吝賜教批評指正。

